Přehled
Integrovaný obvod, anglicky Integrated Circuit, zkráceně IC; jak název napovídá, určitý počet běžně používaných elektronických součástek, jako jsou rezistory, kondenzátory, tranzistory atd., a mezi těmito součástmi Zapojení je obvod se specifickou funkcí integrovanou prostřednictvím polovodičového procesu.
Proč se vyrábějí integrované obvody? Víme, že za každým vynálezem je hybná síla a ta hybná síla často pochází z problémů. Jaké byly tedy problémy před výrobou integrovaných obvodů? Pojďme se podívat na první elektronický počítač na světě, který se zrodil ve Spojených státech v roce 1946. Jde o monstrum, které zabírá plochu 150 metrů čtverečních a váží 30 tun. Obvod uvnitř používá 17 468 elektronek, 7 200 rezistorů, 10 000 kondenzátorů, 500 tisíc linek, spotřeba 150 kilowattů. Je zřejmé, že největší obsazená plocha a neschopnost pohybu jsou nejintuitivnějšími a nejvýraznějšími problémy; kdyby bylo možné tyto elektronické součástky a připojení integrovat na malý nosič, jak skvělé by to bylo! Věříme, že mnoho lidí o tomto problému přemýšlelo a předložilo různé nápady. Typickým příkladem je Dammer, vědec z British Radar Research Institute. Na setkání v roce 1952 navrhl: Diskrétní součástky v elektronickém obvodu mohou být soustředěny na polovodičový čip a malý čip je kompletní obvod. V důsledku toho lze výrazně snížit objem elektronického obvodu a výrazně zlepšit spolehlivost. To byla myšlenka počátečního integrovaného obvodu. Vynález tranzistoru umožnil tuto myšlenku. V roce 1947 byl v Bellových laboratořích ve Spojených státech vyroben první tranzistor. Předtím se funkce současného zesílení mohla spoléhat pouze na velké rozměry a spotřebu energie. Trubice s velkým množstvím elektřiny a křehkou strukturou. Tranzistor má hlavní funkci elektronky a překonává výše uvedené nedostatky elektronky. Proto se po vynálezu tranzistoru brzy objevila myšlenka integrovaného obvodu na bázi polovodiče a integrovaný obvod byl brzy vynalezen. Jack Kilby a Robert Noyce vynalezli v letech 1958 až 1959 germaniové integrované obvody a křemíkové integrované obvody.
Nyní hrají integrované obvody velmi důležitou roli ve všech oblastech života a jsou základním kamenem moderní informační společnosti. Význam integrovaných obvodů při svém zrodu daleko přesáhl rámec své definice, ale jeho stěžejní část, tedy „integrace“, se nezměnila a různé disciplíny z ní odvozené jsou většinou zaměřeny na „integraci“. Tři otázky „co“, „jak se integrovat“ a „jak se vypořádat s klady a zápory integrace“. Hlavním proudem jsou křemíkové integrované obvody, to znamená, že všechny různé součástky potřebné k realizaci určité funkce obvodu jsou umístěny na křemíkovém čipu a vytvořený celek se nazývá integrovaný obvod. Pro „integraci“ může být snazší pochopit dům, ve kterém jsme bydleli: mnoho lidí žilo ve venkovských domech, když byli mladí. V té době mohou být hlavní částí domu tři nebo dva bungalovy, plnící funkci ložnice, s malým dvorkem u vchodu. Pár stolů a židlí slouží jako obývací pokoj a vedle něj stojí malý udírenský nízký domek. Je to kuchyně a toaletu s jedinečnou funkcí je potřeba do jisté míry izolovat. Za domem může být více než deset metrů. ...Později se ve městech nebo při urbanizaci venkova všichni přestěhovali do budov nebo apartmánů. V apartmá jsou obývací pokoje, ložnice, kuchyně, koupelny a balkony. Sice má jen desítky metrů čtverečních, ale má původní výměru pozemku. Různé funkce venkovských domů o rozloze několika set metrů čtverečních jsou integrace.
Samozřejmě, že dnešní integrované obvody jsou mnohem integrovanější než sada. Lepší analogií by snad mohla být moderní budova: v přízemí jsou obchody, kanceláře, jídelny a apartmány v hotelovém stylu. Je zde několik podzemních podlaží s parkovacími místy a pod parkovištěm je základ. Toto je rozložení integrovaných obvodů. Analogový obvod je oddělen od digitálního obvodu. Citlivý obvod, který zpracovává malé signály, je oddělen od řídicí logiky, která často překlápí. Napájecí zdroj je umístěn v rohu. Rozložení pokojů v každém patře je jiné, jiné jsou i chodby. Existují ve tvaru hřbetu, ve tvaru I a ve tvaru několika – toto je návrh zařízení s integrovanými obvody a obvody s nízkým šumem mohou používat složené tvary nebo „interdigitální“ struktury. Tranzistor pro snížení oblasti přechodu a odporu brány. Každé patro je přímo přístupné vysokorychlostními výtahy. Pro efektivitu a funkční izolaci může být více výtahů. Patra, kam se každý výtah dostane, jsou různá – jde o zapojení integrovaných obvodů. Napájecí a zemnící vodiče jsou vedeny odděleně a zátěž je těžká. Linka je také široká; hodiny a signál jsou odděleny; vedení mezi každou vrstvou je vertikální, aby se zabránilo rušení; vysokorychlostní sběrnice mezi CPU a úložištěm je ekvivalentní výtahu a průchozí otvory mezi patry jsou ekvivalentní kabině výtahu...
< h2> VlastnostiIntegrované obvody nebo mikroobvody, mikročipy, čipy jsou druhem obvodu v elektronice (zejména včetně polovodičových součástek, ale i pasivních součástek atd.) Je miniaturizovaný a obvykle se vyrábí na povrchu polovodičového waferu.
Výše uvedené integrované obvody, které vyrábějí obvody na povrchu polovodičových čipů, se také nazývají tenkovrstvé integrované obvody. Dalším typem tlustovrstvého hybridního integrovaného obvodu (hybridní integrovaný obvod) je miniaturizovaný obvod složený z nezávislých polovodičových součástek a pasivních součástek integrovaných do substrátu nebo desky plošných spojů.
Tento článek je o monolitických integrovaných obvodech, tedy tenkovrstvých integrovaných obvodech.
Integrované obvody mají výhody malých rozměrů, nízké hmotnosti, menšího počtu vodičů a pájecích bodů, dlouhé životnosti, vysoké spolehlivosti a dobrého výkonu. Zároveň mají nízkou cenu a jsou vhodné pro hromadnou výrobu. Je široce používán nejen v průmyslových a civilních elektronických zařízeních, jako jsou magnetofony, televizory, počítače atd., ale také ve vojenství, komunikacích a dálkovém ovládání. Použití integrovaných obvodů k montáži elektronických zařízení může zvýšit hustotu montáže desetinásobně až tisíckrát ve srovnání s tranzistory a také lze výrazně zlepšit stabilní pracovní dobu zařízení.
Klasifikace
Funkční struktura
Integrované obvody, také známé jako IC, lze rozdělit na analogové integrované obvody a digitální integrované obvody podle jejich funkcí a struktur. A tři hlavní kategorie digitálních/analogových hybridních integrovaných obvodů.
Analogové integrované obvody, známé také jako lineární obvody, se používají ke generování, zesilování a zpracování různých analogových signálů (označujících signály, jejichž amplituda se mění s časem. Například zvukové signály polovodičových rádií, páskové signály videorekordérů atd. ), Vstupní signál je úměrný výstupnímu signálu. Digitální integrovaný obvod se používá ke generování, zesilování a zpracování různých digitálních signálů (označujících signály s diskrétními hodnotami v čase a amplitudě. Například mobilní telefony 5G, digitální fotoaparáty, počítačové procesory, logické ovládání digitální televize a přehrávání zvukových signálů a video signál).
Výrobní proces
Integrované obvody lze podle výrobního procesu rozdělit na polovodičové integrované obvody a filmové integrované obvody.
Vrstvové integrované obvody se dělí na tlustovrstvé integrované obvody a tenkovrstvé integrované obvody.
Úroveň integrace
Integrované obvody lze rozdělit do různých úrovní integrace:
Integrované obvody SSIC Small Scale
Integrované obvody středního měřítka MSIC (integrované obvody středního měřítka)
LSIC velké integrované obvody (velké integrované obvody)
Obvody integrovaných obvodů velmi velkého měřítka VLSIC (Very Large Scale Integrated Circuits)
Ultra velké integrované obvody ULSIC (Integrované obvody Ultra Large Scale)
Obrovské integrované obvody GSIC se také nazývají velmi velké integrované obvody nebo velmi velké integrované obvody (Giga Scale Integration).
Různé typy vodivosti
Integrované obvody lze podle typu vodivosti rozdělit na bipolární integrované obvody a unipolární integrované obvody. Všechno jsou to digitální integrované obvody.
Výrobní proces bipolárních integrovaných obvodů je komplikovaný a spotřeba energie je poměrně velká, což znamená, že integrované obvody mají typy TTL, ECL, HTL, LST-TL, STTL a další. Unipolární integrované obvody mají jednoduché výrobní procesy, nízkou spotřebu energie a snadno se z nich vyrábějí rozsáhlé integrované obvody. Mezi reprezentativní integrované obvody patří CMOS, NMOS, PMOS a další typy.
Podle aplikace
Podle aplikace lze integrované obvody rozdělit na integrované obvody pro televizory, integrované obvody pro audio, integrované obvody pro video přehrávače, integrované obvody pro videorekordéry a počítače (mikropočítače) . Integrované obvody, integrované obvody pro elektronické klávesnice, integrované obvody pro komunikaci, integrované obvody pro kamery, integrované obvody pro dálkové ovládání, integrované obvody pro jazyk, integrované obvody pro alarmy a různé aplikačně specifické integrované obvody.
1. Televizní integrované obvody zahrnují integrované obvody řádkového a polního skenování, integrované obvody mezizesilovače, integrované obvody zvuku, integrované obvody pro dekódování barev, integrované obvody pro konverzi AV/TV, integrované obvody spínaného napájení a integrované obvody dálkového ovládání Obvody, integrované obvody pro dekódování Nicam, integrované obvody pro zpracování obrazu v obraze, integrované obvody mikroprocesoru (CPU), integrované obvody paměti atd.
2. Mezi audio integrované obvody patří vysokofrekvenční obvody AM/FM, stereo dekódovací obvody, obvody audio předzesilovačů, integrované obvody audio operačních zesilovačů, integrované obvody audio zesilovače výkonu, integrované obvody pro zpracování prostorového zvuku, integrovaný obvod elektroniky Level drive, integrovaný obvod elektronického ovládání hlasitosti , integrovaný obvod se zpožděním dozvuku, integrovaný obvod elektronického spínače atd.
3. Integrované obvody pro přehrávače DVD zahrnují integrované obvody pro řízení systému, integrované obvody pro kódování videa, integrované obvody pro dekódování MPEG, integrované obvody pro zpracování audio signálu, integrované obvody pro zvukové efekty, integrované obvody pro zpracování RF signálu a integrované obvody pro digitální zpracování signálu, integrované obvody pro servomotory, motor pohon integrovaných obvodů atd.
4. Integrované obvody pro videorekordéry zahrnují integrované obvody pro řízení systému, integrované obvody serv, integrované obvody měničů, integrované obvody pro zpracování zvuku a integrované obvody pro zpracování videa.
5. Počítačové integrované obvody, včetně centrální řídicí jednotky (CPU), vnitřní paměti, externí paměti, řídicího obvodu I/O atd.
6. Komunikační integrovaný obvod
7. Profesionální řídicí integrovaný obvod
Klasifikace podle aplikační oblasti
Integrovaný obvod lze klasifikovat podle aplikační oblasti Jedná se o standardní integrovaný obvod pro všeobecné použití a integrovaný obvod pro konkrétní aplikaci.
Podle tvaru
Podle tvaru lze integrovaný obvod rozdělit na kulatý (typ tranzistorového pouzdra s kovovým pouzdrem, obecně vhodný pro vysoký výkon), plochý typ (dobrá stabilita, malá velikost) ) A duální in-line typ.
Stručná historie
Historie vývoje integrovaných obvodů ve světě
1947: John Barding, Bratton a Shockley z Bellových laboratoří ve Spojených státech Vynález tranzistoru je prvním milníkem ve vývoji mikroelektronické technologie;
1950: Zrození přechodového tranzistoru
1950: R Ohl a Shockley vynalezli proces implantace iontů
1951: Vynález tranzistoru s efektem pole
1956: CS Fuller vynalezl proces difúze
1958: Fairchild Robert Noyce a Texas Instruments Kilby vynalezli integrovaný obvod samostatně během několika měsíců, čímž vytvořili historii světové mikroelektroniky;
1960: HH Loor a E Castellani vynalezli proces fotolitografie
1962: Americká společnost RCA vyvinula tranzistory MOS s efektem pole
1963: FMWanlass a CTSah jako první navrhly technologii CMOS. Dnes je více než 95 % čipů integrovaných obvodů založeno na technologii CMOS
1964: Intel Moore navrhl Moorův zákon, který předpovídá, že integrace tranzistorů se každých 18 měsíců zdvojnásobí
1966: Americká společnost RCA vyvinula integrované obvody CMOS a vyvinula první hradlové pole (50 hradel), které položilo pevný základ pro dnešní vývoj rozsáhlých integrovaných obvodů. Je to milník.
1967: Byla založena společnost Applied Materials, která se stala největším světovým výrobcem polovodičových zařízení Company
1971: Společnost Intel uvedla na trh 1kb dynamickou paměť s náhodným přístupem (DRAM), což znamená vznik rozsáhlých integrovaných obvodů
1971: Společnost Intel uvedla na trh první mikroprocesor 4004 na světě. S využitím technologie MOS jde o přelomový vynález
1974: Společnost RCA uvedla na trh první mikroprocesor CMOS 1802
1976: Vychází 16kb DRAM a 4kb SRAM
1978: Zrodila se 64kb dynamická paměť s náhodným přístupem, 140 000 tranzistorů bylo integrováno na křemíkový čip menší než 0,5 centimetrů čtverečních, což znamená příchod éry velmi rozsáhlých integrovaných obvodů (VLSI).
1979: Intel uvedl na trh 5MHz mikroprocesor 8088. Poté IBM uvedla na trh první PC na světě založené na 8088
1981: Vyšlo 256 kb DRAM a 64 kb CMOS SRAM
1984: Japonsko oznámilo uvedení 1Mb DRAM a 256kb SRAM
1985: Vyšel mikroprocesor 80386, 20 MHz
1988: Vyšla 16M DRAM s 35 miliony tranzistorů integrovanými na křemíkovém čipu o rozměru 1 centimetr čtvereční, což znamená vstup do fáze velmi velkých integrovaných obvodů (VLSI).
1989: Na trh vstoupila 1Mb DRAM
1989: Uvedení mikroprocesoru 486, 25MHz, 1μm proces a později 50MHz čip přijal 0,8μm proces
1992: Vyšla 64Mbitová paměť s náhodným přístupem
1993: Uveden na trh 66MHz procesor Pentium s použitím 0,6μm procesu
1995: Pentium Pro, 133 MHz, s použitím 0,6-0,35 μm procesu; 1997: Vyšlo 300MHz Pentium II s použitím 0,25μm procesu
1999: Pentium III vyšlo, 450 MHz, pomocí 0,25μm procesu, později pomocí 0,18μm procesu
2000: Na trh byla uvedena 1Gb RAM
2000: Pentium 4 vyšlo, 1,5 GHz, s použitím 0,18μm procesu
2001: Intel oznámil použití 0,13μm procesu v druhé polovině roku 2001.
2003: Byla uvedena řada Pentium 4 E využívající 90nm proces.
2005: Byla uvedena řada Intel Core 2 využívající 65nm proces.
2007: Uveden na trh Intel Core 2 E7/E8/E9 založený na novém 45nm High-K procesu.
2009: Nově byla uvedena řada Intel Core i využívající rekordní 32nanometrový proces a další generace 22nanometrového procesu je ve vývoji.
Historie vývoje čínského integrovaného obvodu
Čínský průmysl integrovaných obvodů se zrodil v 60. letech 20. století a prošel třemi fázemi vývoje:
1965-1978: S cílem počítačového a vojenského vybavení jako cílem, s vývojem logických obvodů jako hlavním produktem, počáteční založení průmyslové nadace integrovaných obvodů a podpůrné podmínky pro související vybavení, nástroje a materiály
1978-1990: Převážně dovážené zařízení z druhé ruky ze Spojených států amerických , Pro zlepšení úrovně vybavení integrovaných obvodů, při „kontrole chaosu“ a zaměření na spotřební zboží jako nosný bod, vyřešila lokalizaci integrovaného barevného televizoru obvody.
1990-2000: Zaměříme se na Projekt 908 a Projekt 909, s CAD jako průlom, odvedeme dobrou práci ve vědeckém a technologickém výzkumu a při budování severní vědecké výzkumné a vývojové základny, která bude sloužit informačnímu průmyslu, a průmysl integrovaných obvodů učinil nový vývoj.
Odvětví integrovaných obvodů je celkovým popisem tržního prodeje každého článku v průmyslovém řetězci integrovaných obvodů. Zahrnuje nejen trh s integrovanými obvody, ale také trh jádra IP, trh EDA, trh sléváren čipů a trh balení a testování. , A dokonce rozšířit na trhy vybavení a materiálů.
Odvětví integrovaných obvodů se již nespoléhá na vývoj jednotlivých zařízení, jako je CPU a paměť. Mobilní internet, triple play, interakce na více obrazovkách a chytré terminály přinesly několik tržních prostorů. Neustálá inovace obchodních modelů vnesla na trh novou vitalitu. . V současnosti má průmysl integrovaných obvodů v mé zemi určitý základ. V průběhu let průmysl integrovaných obvodů mé země nashromáždil vitalitu technologických inovací, možnosti rozšíření trhu, sílu integrace zdrojů a široký tržní potenciál, což pomůže odvětví dosáhnout rychlého rozvoje a pokroku v příštích 5 až 10 letech. Základ položil nový krok.
Zdravý rozum při testování
1. Před testováním musíte pochopit princip fungování integrovaných obvodů a souvisejících obvodů.
Před kontrolou a opravou integrovaných obvodů se musíte nejprve seznámit s použitými integrovanými obvody. Funkce, vnitřní obvod, hlavní elektrické parametry, role každého pinu a princip činnosti obvodu složeného z normálního napětí, tvaru vlny a periferních součástí pinu.
2. Otestujte, aby nedošlo ke zkratu mezi kolíky
Při měření napětí nebo testování tvaru vlny osciloskopickou sondou se vyvarujte zkratu mezi kolíky, nejlépe na periferii přímo připojené ke kolíkům. Měření se provádí na tištěném spoji. Jakýkoli momentální zkrat může snadno poškodit integrovaný obvod, zejména při testování plochých integrovaných obvodů CMOS.
3. Je přísně zakázáno používat uzemněné testovací zařízení k dotyku živého TV, audio, video a dalšího zařízení na spodní desce bez izolačního transformátoru.
Je přísně zakázáno používat přístroje s uzemněným pláštěm Zařízení přímo testuje TV, audio, video a další zařízení bez napájecího izolačního transformátoru. Obecný radiomagnetofon má sice napájecí transformátor, ale když přijdete do kontaktu se speciálním televizním nebo audio zařízením, zejména výstupním výkonem nebo povahou použitého napájecího zdroje, musíte nejprve zjistit, zda je šasi stroje nabité , jinak to bude velmi snadné Televizor, audio a další zařízení, která jsou nabíjena na backplane, způsobují zkrat napájecího zdroje, který ovlivňuje integrovaný obvod a způsobuje další rozšíření poruchy.
4. Věnujte pozornost izolačnímu výkonu elektrické páječky
Není dovoleno používat páječku, když je pod napětím. Ujistěte se, že páječka není pod napětím. Nejlepší je uzemnit plášť páječky a opatrněji s obvodem MOS. , Je bezpečnější používat 6~8V nízkonapěťovou elektrickou páječku.
5. Musíme zajistit kvalitu svařování
Při svařování je svařování jisté a nahromadění pájky a pórů snadno způsobí falešné svařování. Doba pájení obecně není delší než 3 sekundy a výkon páječky by měl být asi 25 W s vnitřním ohřevem. Integrovaný obvod, který byl připájen, by měl být pečlivě zkontrolován. Nejlepší je pomocí ohmmetru změřit, zda nedošlo ke zkratu mezi kolíky, potvrdit, že nedochází k přilnutí pájky, a poté zapnout napájení.
6. Poškození integrovaného obvodu neposuzujte snadno
Neposuzujte poškození integrovaného obvodu snadno. Protože většina integrovaných obvodů je přímo propojena, jakmile je obvod abnormální, může způsobit vícenásobné změny napětí a tyto změny nemusí být nutně způsobeny poškozením integrovaného obvodu. Kromě toho se v některých případech naměřené napětí každého pinu liší od normálního napětí. Když se hodnoty shodují nebo jsou blízko, nemusí to vždy znamenat, že integrovaný obvod je dobrý. Protože některé měkké poruchy nezpůsobí změny stejnosměrného napětí.
7. Vnitřní odpor testovacího přístroje by měl být velký
Při měření stejnosměrného napětí pinu integrovaného obvodu by měl být zvolen multimetr s vnitřním odporem hlavy měřiče větším než 20KΩ/V, jinak bude ovlivněn některými piny. Napětí bude mít velkou chybu měření.
8. Dávejte pozor na odvod tepla výkonového integrovaného obvodu
Výkonový integrovaný obvod by měl mít dobrý odvod tepla a není dovoleno pracovat ve stavu s vysokým výkonem bez chladiče.
9. Vedení by mělo být rozumné
Pokud potřebujete přidat externí součástky, abyste nahradili poškozenou část integrovaného obvodu, měly by být použity malé součástky a kabeláž by měla být rozumná, aby se zabránilo zbytečné parazitní vazbě, zejména kvůli vypořádání se s uzemňovací svorkou mezi zesilovačem zvuku integrovaný obvod a obvod předzesilovače.
Význam každé části modelu integrovaného obvoduČást 0
Část 1
Část 2
Část 3
Část IV
Symboly
Význam
Přizpůsobte se
Význam
Význam
Symbol
Význam
Vyhovující
Význam
C
C znamená
< p>Vyrobeno v ČíněT
Obvod TTL
Použijte digitální měřič
Zobrazit sériový kód zařízení
C
0~70℃
F
Vícevrstvá keramická plochá
H
HTL obvod
G
-25~70℃
B
plastový plochý
E
Obvod ECL
L
‐24~85℃
H
Plocha z černého porcelánu
C
Obvod CMOS
E
-40~85℃
D
Více Layer keramické dual in-line
M
paměť
R
‐55~85℃
J
Černá porcelánová dvojitá in-line zástrčka
µ
Mikropočítačový obvod
M
‐55~125 ℃
P
Plastový duální in-line
F
Lineární zesilovač
S
Plastový jednoduchý in-line konektor
W
Stabilizátor
K
Kovový diamant
B< /p>
Nelineární obvod
T
Kovový kruh
J
Obvod rozhraní
C
Keramický nosič čipů
AD
A/D převodník
E
Plastový nosič čipů
DA
D/A převodník
G
Zobrazení síťové mřížky
D
Audio, TV okruh
SC
Okruh vyhrazený pro komunikaci
SS
Citlivý obvod
SW
Sledovací okruh
Například: Schottkyho 4vstupová brána NAND CT54S20MD
C – V souladu s národními normami
T—Obvod TTL
54S20 – Schottkyho duální 4vstupová brána NAND
M—55~125℃
D – Vícevrstvý keramický duální in-line balíček
1, BGA
(pole kulové mřížky)
Pole kulových kontaktů, jeden z balíčků pro povrchovou montáž. Na zadní straně potištěného substrátu je vytvořeno pole kulových hrbolků, které nahrazují kolíky, a čip LSI se sestaví na přední část potištěného substrátu a poté se utěsní lisováním pryskyřice nebo zaléváním. Také se nazývá nosič nárazového pole (PAC). Pinů může přesáhnout 200, což je balíček pro vícepinové LSI. Tělo obalu může být také menší než QFP (Quad Flat Package). Například 360kolíkový BGA se středovou vzdáleností kolíků 1,5 mm je pouze 31 mm čtverečních; zatímco 304kolíkový QFP se středovou vzdáleností kolíků 0,5 mm je 40 mm čtverečních. A BGA se nemusí obávat problémů s deformací pinů jako QFP (viz obrázek).
2, BQFP
(plochý čtyřdílný balíček s nárazníkem)
Čtyřplochý balíček s nárazníkem. V jednom z obalů QFP jsou ve čtyřech rozích těla obalu umístěny výstupky (nárazové podložky), které zabraňují ohýbání a deformaci kolíků během přepravy. Američtí výrobci polovodičů používají tento balíček hlavně v obvodech, jako jsou mikroprocesory a ASIC. Středová vzdálenost kolíku je 0,635 mm a číslo kolíku je přibližně 84 až 196 (viz QFP).
3, C –
(keramika)
představuje značku keramického obalu. Například CDIP znamená keramický DIP. Je to značka, která se v praxi často používá.
4, Cerdip
Keramické duální in-line pouzdro utěsněné sklem, používané pro ECL RAM, DSP (digitální signálový procesor) a další obvody. Cerdip se skleněným okénkem se používá pro ultrafialovou vymazatelnou EPROM a obvody mikropočítačů s EPROM uvnitř. Středová vzdálenost kolíků je 2,54 mm a počet kolíků je od 8 do 42. V Japonsku je toto balení vyjádřeno jako DIP-G (G znamená skleněné těsnění).
5. Cerquad
Jeden z obalů pro povrchovou montáž, tj. keramický QFP utěsněný vespod, který se používá k balení logických obvodů LSI, jako je DSP. Cerquad s okny se používá k zapouzdření obvodů EPROM. Odvod tepla je lepší než u plastového QFP a může tolerovat výkon 1,5 ~ 2W za podmínek přirozeného chlazení vzduchem. Ale náklady na balení jsou 3 až 5krát vyšší než u plastových QFP. Středová vzdálenost kolíků má různé specifikace, jako je 1,27 mm, 0,8 mm, 0,65 mm, 0,5 mm, 0,4 mm a tak dále. Počet kolíků se pohybuje od 32 do 368.
Keramický nosič čipů s kolíky, jeden z obalů pro povrchovou montáž, kolíky jsou vyvedeny ze čtyř stran obalu do tvaru T. Slouží k zapouzdření ultrafialově vymazatelné EPROM a obvodu mikropočítače s EPROM s okny. Tento balíček se také nazývá QFJ, QFJ-G (viz QFJ).
6, COB
(čip na desce)
Balení čipu na desce je jednou z technologií montáže holého čipu. Na desce plošných spojů je elektrické spojení mezi čipem a substrátem realizováno metodou drátového stehování a elektrické spojení mezi čipem a substrátem je realizováno metodou drátového stehování a je pokryto pryskyřicí, aby byla zajištěna spolehlivost. Ačkoli COB je nejjednodušší technologie montáže holým čipem, jeho hustota balení je mnohem nižší než u technologie TAB a flip-chip bonding.
7, DFP
(dvojitý plochý balíček)
Dvojitý plochý balíček. Je to jiný název pro SOP (viz SOP). Dříve se tomu tak říkalo, ale koncem 80. let se v podstatě nepoužívalo.
8, DIC
(dvojité keramické balení v řadě)
Jiný název pro keramický DIP (včetně skleněného těsnění) (viz DIP).
9, DIL
(duální in-line)
Jiný název pro DIP (viz DIP). Evropští výrobci polovodičů často používají tento název.
10, DIP
(dvojitý in-line balíček)
Duální in-line balíček. Jeden ze zásuvných obalů, kolíky jsou vytaženy z obou stran obalu a materiály obalu jsou plast a keramika. DIP je nejoblíbenější zásuvný modul a jeho aplikační rozsah zahrnuje standardní logické integrované obvody, paměťové LSI a obvody mikropočítačů. Středová vzdálenost kolíků je 2,54 mm a počet kolíků je od 6 do 64. Šířka balení je obvykle 15,2 mm. Některé obaly o šířce 7,52 mm a 10,16 mm se nazývají skinny DIP a slim DIP (úzký DIP). Ale ve většině případů se nerozlišuje a jsou jednoduše souhrnně označovány jako DIP. Kromě toho se keramický DIP zatavený nízkotavným sklem nazývá také cerdip (viz cerdip).
11, DSO
(dvojitý malý odřezek)
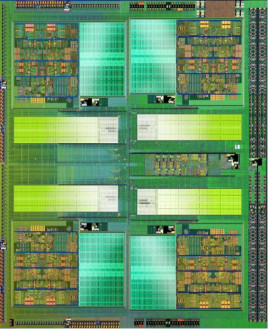
Dvounásobný malý odlučovací balíček. Jiný název pro SOP (viz SOP). Někteří výrobci polovodičů používají tento název.
12, DICP
(balení nosiče se dvěma páskami)
Oboustranný balíček nosiče olova. Jeden z TCP (Tape Carrier Package). Kolíky jsou vyrobeny na izolační pásce a vyvedeny z obou stran obalu. Díky použití technologie TAB (automatické svařování páskou) je obrys obalu velmi tenký. Často se používá v ovladači displeje z tekutých krystalů LSI, ale většina z nich jsou zakázkové produkty. Ve fázi vývoje je navíc 0,5 mm tlustý paměťový LSI balíček. V Japonsku se DICP nazývá DTP v souladu se standardy asociace EIAJ (Electronic and Mechanical Industries of Japan).
13, DIP
(balení nosiče se dvěma páskami)
Tamtéž. Japonský standard Electronic Machinery Industry Association jmenuje DTCP (viz DTCP).
14, FP
(plochý balíček)
Plochý balíček. Jeden z balíčků pro povrchovou montáž. Jiný název pro QFP nebo SOP (viz QFP a SOP). Někteří výrobci polovodičů používají tento název.
15, flip-chip
Flip-chip svařování. Jednou z technologií balení holých čipů je vytvoření kovových hrbolků v oblasti elektrody čipu LSI a následné spojení kovových hrbolků s oblastí elektrod na desce s plošnými spoji. Půdorys obalu je v podstatě stejný jako velikost čipu. Je nejmenší a nejtenčí ze všech obalových technologií. Pokud je však koeficient tepelné roztažnosti substrátu odlišný od koeficientu LSI čipu, dojde ve spoji k reakci, která ovlivní spolehlivost spoje. Proto je nutné použít pryskyřici pro vyztužení čipu LSI a použít materiál substrátu s v podstatě stejným koeficientem tepelné roztažnosti.
16, FQFP
(veliký plochý balíček s jemným roztečem)
Malá středová vzdálenost QFP. Obvykle se vztahuje na QFP se středovou vzdáleností vývodu menší než 0,65 mm (viz QFP). Někteří výrobci vodičů používají tento název.
17, CPAC
(přenašeč pole globe top pad pole)
Přezdívka americké společnosti Motorola pro BGA (viz BGA).
18, CQFP
(balíček quad fiat s ochranným kroužkem)
Ploché balení se čtyřmi kolíky s ochranným kroužkem. Jeden z plastových QFP, kolíky jsou maskovány pryskyřičným ochranným kroužkem, aby se zabránilo ohýbání a deformaci. Před montáží LSI na desku s plošnými spoji odřízněte přívod z ochranného kroužku a vytvořte jej do tvaru křídla racka (tvar L). Tento balíček byl sériově vyráběn společností Motorola ve Spojených státech. Středová vzdálenost kolíků je 0,5 mm a počet kolíků je maximálně asi 208.
19, H-
(s chladičem)
znamená označení s chladičem. Například HSOP znamená SOP s chladičem.
20, pole mřížky pinů
(typ povrchové montáže)
PGA pro povrchovou montáž. PGA je obvykle zásuvný balíček s délkou kolíku asi 3,4 mm. Povrchová montáž PGA má na spodní straně obalu kolíky podobné displeji a délka se pohybuje od 1,5 mm do 2,0 mm. Montáž využívá metodu svařování na tupo s deskou plošných spojů, proto se také nazývá svařování na tupo PGA. Vzhledem k tomu, že středová vzdálenost kolíků je pouze 1,27 mm, což je o polovinu menší než u zásuvného typu PGA, tělo pouzdra nemůže být tak velké a počet kolíků je větší než u zásuvného typu (250~ 528), což je balíček pro rozsáhlé logické LSI. . Obalové substráty zahrnují vícevrstvé keramické substráty a skleněné epoxidové pryskyřicové tiskové základny. Balení vícevrstvých keramických substrátů bylo uvedeno do praktického využití.
21, JLCC
(nosič čipu s vývodem J)
Nosič čipů s vývodem J. Jiný název pro CLCC s oknem a keramické QFJ s oknem (viz CLCC a QFJ). Název převzatý některými výrobci polovodičů.
22, LCC
(Bezvodičový nosič čipu)
Bezvodičový nosič čipu. Odkazuje na obal pro povrchovou montáž, ve kterém jsou čtyři strany keramického substrátu v kontaktu pouze s elektrodami bez vývodů. Jedná se o vysokorychlostní a vysokofrekvenční IC balíček, nazývaný také keramický QFN nebo QFN-C (viz QFN).
23, LGA
(pole zemské mřížky)
Kontaktujte balíček zobrazení. To znamená, že na spodním povrchu je vytvořen balíček s kontakty elektrod ve stavu pole. Při montáži stačí zapojit do zásuvky. Keramické LGA s 227 kontakty (středová vzdálenost 1,27 mm) a 447 kontakty (středová vzdálenost 2,54 mm) byly prakticky použity ve vysokorychlostních logických obvodech LSI. Ve srovnání s QFP může LGA pojmout více vstupních a výstupních pinů v menším balení. Navíc, protože impedance přívodu je malá, je velmi vhodný pro vysokorychlostní LSI. Kvůli komplikované výrobě a vysoké ceně patic se však v 90. letech v podstatě nepoužívaly. Očekává se, že jeho poptávka v budoucnu poroste.
24, LOC
(olovo na čipu)
olovo na balíčku čipu. Jedna z technologií balení LSI, struktura, ve které je přední konec olověného rámečku nad čipem a nárazové pájené spoje jsou vyrobeny blízko středu čipu a pro elektrické připojení se používá drátové sešívání. Ve srovnání s původní strukturou, kde je olověný rámeček uspořádán poblíž strany čipu, je čip obsažený v balení stejné velikosti široký asi 1 mm.
25, LQFP
(nízkoprofilový čtyřplošný balíček)
Tenký QFP. Odkazuje na QFP s tloušťkou těla obalu 1,4 mm, což je název používaný japonským průmyslem elektronických strojů podle nového formulovaného tvarového faktoru QFP.
26, L-QUAD
Jeden z keramických QFP. Nitrid hliníku používaný pro obalové substráty má tepelnou vodivost 7-8krát vyšší než oxid hlinitý a má lepší odvod tepla. Rám obalu je z oxidu hlinitého a čip je utěsněn zalitím, čímž se snižují náklady. Jedná se o balíček vyvinutý pro logické LSI, který dokáže tolerovat výkon W3 za podmínek přirozeného chlazení vzduchem. Byly vyvinuty 208kolíkové (0,5 mm středová vzdálenost) a 160pinové (0,65 mm středová vzdálenost) logické balíčky LSI a sériová výroba byla zahájena v říjnu 1993.
27, MCM
(vícečipový modul)
Multičipový modul. Pouzdro, ve kterém je na elektroinstalačním substrátu sestaveno více polovodičových holých čipů. Podle materiálu substrátu jej lze rozdělit do tří kategorií: MCM-L, MCM-C a MCM-D. MCM-L je součástka využívající běžnou skleněnou epoxidovou vícevrstvou desku s plošnými spoji. Hustota zapojení není příliš vysoká a náklady jsou nízké. MCM-C používá tlustovrstvou technologii k vytvoření vícevrstvého vedení a jako substrátovou komponentu používá keramiku (oxid hlinitý nebo sklokeramiku), který je podobný tlustovrstvému hybridnímu IC využívajícímu vícevrstvý keramický substrát. Mezi těmito dvěma není žádný zjevný rozdíl. Hustota vedení je vyšší než u MCM-L.
MCM-D je použití technologie tenkých vrstev k vytvoření vícevrstvého vedení s keramikou (oxid hliníku nebo nitrid hliníku) nebo Si, Al jako substrátovou složkou. Schéma zapojení je ze všech tří komponent nejvyšší, ale náklady jsou také vysoké.
28, MFP
(mini plochý balíček)
Malé ploché balení. Jiný název pro plastový SOP nebo SSOP (viz SOP a SSOP). Název převzatý některými výrobci polovodičů.
29, MQFP
(metrický čtyřnásobný plochý balíček)
Klasifikace QFP podle standardů JEDEC (United Electronic Equipment Council). Odkazuje na standardní QFP se středovou vzdáleností vývodu 0,65 mm a tloušťkou těla 3,8 mm až 2,0 mm (viz QFP).
30, MQUAD
(kovová čtyřka)
Balík QFP vyvinutý společností American Olin Company. Základní deska i kryt jsou vyrobeny z hliníku a utěsněny lepidlem. Za podmínek přirozeného chlazení vzduchem lze tolerovat výkon 2,5 W až 2,8 W. Japonská společnost Shinko Electric Industry Co., Ltd. získala v roce 1993 licenci na zahájení výroby.
31, MSP
(mini čtvercový balíček)
Jiný název pro QFI (viz QFI), který se v raných fázích vývoje často nazývá MSP. QFI je název předepsaný Japonskou asociací elektronického strojního průmyslu.
34, OPMAC (přes lisovaný nosič pole pad)
Nosič displeje s těsněním z lisované pryskyřice. Název přijatý společností American Motorola Company pro lisované pryskyřicové těsnění BGA (viz BGA).
32, P-
(plast)
představuje symbol plastového obalu. Například PDIP znamená plastový DIP.
33, PAC
(nosič pole pad)
Bump display carrier, jiný název pro BGA (viz BGA).
34, PCLP
(bezolovnatý balíček desky s plošnými spoji)
Balíček bezolovnatých desek s plošnými spoji. Název přijatý společností Fujitsu pro plastové QFN (plastové LCC) (viz QFN). Úvod
Existují dvě specifikace 0,55 mm a 0,4 mm pro středovou vzdálenost mezi nohama.
35, PFPF
(plastový plochý balíček)
Plastový plochý obal. Jiný název pro plastový QFP (viz QFP). Název převzatý některými výrobci LSI.
36, PGA
(pole pin mřížky)
Zobrazit balíček pinů. Jeden ze zásuvných balíčků, vertikální kolíky na spodní ploše jsou uspořádány v poli. Obalové substráty jsou v podstatě vícevrstvé keramické substráty. V případě, že název materiálu není konkrétně uveden, jde většinou o keramické PGA, které se používají ve vysokorychlostních rozsáhlých logických obvodech LSI. Cena je vyšší. Středová vzdálenost mezi kolíky je obvykle 2,54 mm a počet kolíků se pohybuje od 64 do 447. Za účelem snížení nákladů lze obalový substrát nahradit substrátem s potištěným sklem epoxidem. Existují také plastové PGA s 64 až 256 piny. Kromě toho je k dispozici povrchová montáž PGA s krátkými kolíky (na tupo svařované PGA) se středovou vzdáleností kolíků 1,27 mm. (Viz povrchová montáž PGA).
37, prasátko
Balík s prasátkem. Vztahuje se na keramické balení s paticí, tvar je podobný DIP, QFP, QFN. Používá se k vyhodnocení operace potvrzení programu při vývoji zařízení s mikropočítačem. Například zasuňte EPROM do zásuvky pro ladění. Tento druh balení je v podstatě vyroben na zakázku a není uveden na trh.
38, PLCC
(plastový olovnatý nosič čipů)
Plastový olovnatý nosič čipů. Jeden z balíčků pro povrchovou montáž. Čepy jsou vyvedeny ze čtyř stran obalu, mají tvar T a jsou vyrobeny z plastu. Společnost Texas Instruments poprvé přijala 64kbitovou DRAM a 256kDRAM ve Spojených státech a v 90. letech byla popularizována v logických LSI, DLD (neboli obvody logických zařízení). Středová vzdálenost kolíků je 1,27 mm a počet kolíků se pohybuje od 18 do 84. J Tvarovaný kolík se nedá snadno deformovat a snadněji se ovládá než QFP, ale kontrola vzhledu po pájení je obtížnější. PLCC je podobný LCC (také známý jako QFN). Předtím je rozdíl mezi těmito dvěma pouze v tom, že první používá plast a druhý používá keramiku. Ale nyní má Vzhled J-olovených obalů z keramiky a bezolovnatých obalů z plastů (označených jako plastic LCC, PC LP, P-LCC atd.) byl k nerozeznání. Z tohoto důvodu se Japonská elektromechanická průmyslová asociace v roce 1988 rozhodla. Obal s kolíky ve tvaru J vytaženými ze čtyř stran se nazývá QFJ a obal s elektrodovými hrbolky na čtyřech stranách se nazývá QFN (viz QFJ a QFN).
39, P-LCC
39; /p>
(plastový nosič čipů bez struny) (plastový olovnatý nosič čipů)
Někdy je to jiný název pro plastový QFJ a někdy je to jiný název pro QFN (plastický LCC) (viz QFJ a QFN). Nějaký
Výrobci LSI používají PLCC pro olověné pouzdro a P-LCC pro bezolovnaté pouzdro, aby ukázali rozdíl.
40, QFH
(čtyřnásobný plochý vysoký balíček)
四侧引脚厚体扁平封装。塑料QFP 的一种,为了防止封装本体断裂,QFP 本体制作得较厚(见QFP)。部分半导体厂家采用的名称。< /p>
41, QFI
(quad flat I-leaded packgac)
四侧I 形引脚扁平封装。表面贴装型封装之一。引脚从封装四个侧面引出,向下呈I 字。 也称为MSP(见MSP)。贴装与印刷基板进行碰焊连接。由于引脚无突出部分,贴装占有面积小于QFP。 日立制作所为视频模拟IC 开发并使用了这种封装。此外,日本的Motorola 公司的PLL IC 也采用了此种封装。引脚中心距1.27mm,引脚数从18 于68。
42 、QFJ
(balík se čtyřmi plochými J-olovem)
四侧J 形引脚扁平封装。表面贴装封装之一。引脚从封装四个侧面引出,向下呈J字形。是日本电子机械工业会规定的名称。引脚中心距1.27mm。
材料有塑料和陶瓷两种。塑料QFJ 多数情况称为PLCC(见PLCC) ,用于微机、门陈列、 DRAM、ASSP、OTP 等电路。引脚数从18 至84。
陶瓷QFJ 也称为CLCC、JLCC(见CLCC)。带窗口的封装用于紫外线擦除型EPROM 以及带有EPROM 的微机芯片电路。引脚数从32 至84。
43、QFN
(čtyřnásobný plochý bezolovnatý balíček)
四侧无引脚扁平封装。表面贴装型封装之一。 90年代后期多称为LCC。 QFN 是日本电子机械工业 会规定的名称。封装四侧配置有电极触点,由于无引脚,贴装占有面积比QFP 小,高度 比QFP 低。但是,当印刷基板与封装之间产生应力时,在电极接触处就不能得到缓解。因此电 极触点 难于作到QFP 的引脚那样多,一般从14 到100 左右。材料有陶瓷和塑料两种。当有LCC 标记时基本上都是陶瓷QFN。电极触点中心距1.27mm。
塑料QFN 是以玻璃环氧树脂印刷基板基材的一种低成本封装。电极触点中心距除1.27mm 外, 还有0.65mm 和0.5mm 两种。这种封装也称为塑料LCC、PCLC、P-LCC 等。
44, QFP
(čtyřnásobný plochý balíček)
四侧引脚扁平封装。表面贴装型封装之一,引脚从四个侧面引出呈海鸥翼(L)型。基材有 陶 瓷、金属和塑料三种。从数量上看,塑料封装占绝大部分。当没有特别表示出材料时, 多数情 况为塑料QFP。塑料QFP 是最普及的多引脚LSI 封装。不仅用于微处理器,门陈列等数字 逻辑LSI 电路,而且也用于VTR 信号处理、音响信号处理等模拟LSI 电路。引脚中心距 有1.0mm、0.8mm、 0.65mm、0.5mm、0.4mm、0.3mm 等多种规格。 0.65mm 中心距规格中最多引脚数为304。
日本将引脚中心距小于0.65mm 的QFP 称为QFP(FP)。但2000年后日本电子机械工业会对QFP 的外形规格进行了重新评价。在引脚中心距上不加区别,而是根据封装本体厚度分为 QFP(2.0mm~3.6mm 厚)、LQFP(1.4mm 厚)和TQFP(1.0mm 厚)三种。
另外,有的LSI 厂家把引脚中心距为0.5mm 的QFP 专门称为收缩型QFP 或SQFP、VQFP。但有的厂家把引脚中心距为0.65mm 及0.4mm 的QFP 也称为SQFP,至使名称稍有一些混乱 。 QFP 的缺点是,当引脚中心距小于0.65mm 时,引脚容易弯曲。为了防止引脚变形,现已 出现了几种改进的QFP 品种。如封装的四个角带有树指缓冲垫的BQFP(见BQFP);带树脂 保护 环覆盖引脚前端的GQFP(见GQFP);在封装本体里设置测试凸点、放在防止引脚变形的专 用夹 具里就可进行测试的TPQFP(见TPQFP)。在逻辑LSI 方面,不少开发品和高可靠品都封装在多层陶瓷QFP 里。引脚中心距最小为 0.4mm、引脚数最多为348 的产品也已问世。此外,也有用玻璃密封的陶瓷QFP(见Gerqa d)。
45, QFP
(FP) (jemná výška QFP)
小中心距QFP。日本电子机械工业会标准所规定的名称。指引脚中心距为0.55mm、0.4mm 、 0.3mm 等小于0.65mm 的QFP(见QFP)。
46、QIC
(keramický balíček se čtyřmi in-line)
陶瓷QFP 的别称。部分半导体厂家采用的名称(见QFP、Cerquad)。
47, QIP
(plastový balíček se čtyřmi řadami)
塑料QFP 的别称。部分半导体厂家采用的名称(见QFP)。
48、QTCP
(balíček nosiče se čtyřmi páskami)
四侧引脚带载封装。 TCP 封装之一,在绝缘带上形成引脚并从封装四个侧面引出。是利 用 TAB 技术的薄型封装(见TAB、TCP)。
49, QTP
(balíček nosiče se čtyřmi páskami)
四侧引脚带载封装。日本电子机械工业会于1993 年4 月对QTCP 所制定的外形规格所用 的 名称(见TCP)。
50、QUIL
(čtyřka v řadě)
QUIP 的别称(见QUIP)。
51、QUIP
(čtyřčlenný in-line balíček)
四列引脚直插式封装。引脚从封装两个侧面引出,每隔一根交错向下弯曲成四列。引脚 中 心距1.27mm,当插入印刷基板时,插入中心距就变成2.5mm。因此可用于标准印刷线路板。是 比标准DIP 更小的一种封装。日本电气公司在台式计算机和家电产品等的微机芯片中采 用了些 种封装。材料有陶瓷和塑料两种。引脚数64。
52, SDIP
(zmenšit duální in-line balíček)
收缩型DIP。插装型封装之一,形状与DIP 相同,但引脚中心距(1.778mm)小于DIP(2.54 mm),
因而得此称呼。引脚数从14 到90。也有称为SH-DIP 的。材料有陶瓷和塑料两种。
53、SH – DIP
(zmenšit duální in-line balíček)
同SDIP。部分半导体厂家采用的名称。
54、SIL
(jeden v řadě)
SIP 的别称(见SIP)。欧洲半导体厂家多采用SIL 这个名称。
55, SIMM
(jeden in-line paměťový modul)
单列存贮器组件。只在印刷基板的一个侧面附近配有电极的存贮器组件。通常指插入插 座 的组件。标准SIMM 有中心距为2.54mm 的30 电极和中心距为1.27mm 的72 电极两种规格 。在印刷基板的单面或双面装有用SOJ 封装的1 兆位及4 兆位DRAM 的SIMM 已经在个人 计算机、工作站等设备中获得广泛应用。至少有30~40%的DRAM 都装配在SIMM 里。
56, SIP
(jeden vložený balíček)
单列直插式封装。引脚从封装一个侧面引出,排列成一条直线。当装配到印刷基板上时 封 装呈侧立状。引脚中心距通常为2.54mm,引脚数从2 至23,多数为定制产品。封装的形 状各 异。也有的把形状与ZIP 相同的封装称为SIP。
57、SK – DIP
(hubený dvojitý in-line balíček)
DIP 的一种。指宽度为7.62mm、引脚中心距为2.54mm 的窄体DIP。通常统称为DIP(见 DIP)。
58、SL – DIP
(tenký dvojitý in-line balíček)
DIP 的一种。指宽度为10.16mm,引脚中心距为2.54mm 的窄体DIP。通常统称为DIP。
59, SMD
(zařízení pro povrchovou montáž)
表面贴装器件。偶而,有的半导体厂家把SOP 归为SMD(见SOP)。
SOP 的别称。世界上很多半导体厂家都采用此别称。 (见SOP)。
60, SOI
(malý balíček s označením I)
I 形引脚小外型封装。表面贴装型封装之一。引脚从封装双侧引出向下呈I 字形,中心 距 1.27mm。贴装占有面积小于SOP。日立公司在模拟IC(电机驱动用IC)中采用了此封装。引 脚数 26。
61、SOIC
(malý integrovaný obvod)
SOP 的别称(见SOP)。国外有许多半导体厂家采用此名称。
62、SOJ
(Small Out-Line J-Leaded Package)
J 形引脚小外型封装。表面贴装型封装之一。引脚从封装两侧引出向下呈J 字形,故此 得名。通常为塑料制品,多数用于DRAM 和SRAM 等存储器LSI 电路,但绝大部分是DRAM。用SO J 封装的DRAM 器件很多都装配在SIMM 上。引脚中心距1.27mm,引脚数从20 至40(见SIMM )。
63、SQL
(Malý balíček Out-Line s vývodem do L)
按照JEDEC(美国联合电子设备工程委员会)标准对SOP 所采用的名称(见SOP)。
64、SONF
(malý obrys bez ploutví)
无散热片的SOP。与通常的SOP 相同。为了在功率IC 封装中表示无散热片的区别,有意 增添了NF(non-fin)标记。部分半导体厂家采用的名称(见SOP)。
65, SOP
(malý balíček Out-Line)
小外形封装。表面贴装型封装之一,引脚从封装两侧引出呈海鸥翼状(L 字形)。材料有 塑料 和陶瓷两种。另外也叫SOL 和DFP。
SOP 除了用于存储器LSI 外,也广泛用于规模不太大的ASSP 等电路。在输入输出端子不 超过10~40 的领域,SOP 是普及最广的表面贴装封装。引脚中心距1.27mm,引脚数从8 ~44。
另外,引脚中心距小于1.27mm 的SOP 也称为SSOP;装配高度不到1.27mm 的SOP 也称为 TSOP(见SSOP、TSOP)。还有一种带有散热片的SOP。
66, SOW
(Malý balíček Outline (Wide-Jype))
宽体SOP。部分半导体厂家采用的名称。
制造
从1930年代开始,元素周期表中的化学元素中的半导体被研究者如贝尔实验室的William Shockley认为是固态真空管的最可能的原料。从氧化铜到锗,再到硅,原料在1940到1950年代被系统的研究。今天,尽管元素周期表的一些III-V价化合物如砷化镓应用于特殊用途如:发光二极管,激光,太阳能电池和最高速集成电路,单晶硅成为集成电路主流的基层。创造无缺陷晶体的方法用去了数十年的时间。
半导体IC制程,包括以下步骤,并重复使用:
黄光(微影)
蚀刻
薄膜
扩散
CMP
使用单晶硅晶圆(或III-V族,如砷化镓)用作基层。然后使用微影、扩散、CMP等技术制成MOSFET或BJT等组件,然后利用微影、薄膜、和CMP技术制成导线,如此便完成芯片制作。因产品性能需求及成本考量,导线可分为铝制程和铜制程。
IC 由很多重叠的层组成,每层由图像技术定义,通常用不同的颜色表示。一些层标明在哪里不同的掺杂剂扩散进基层(成为扩散层),一些定义哪里额外的离子灌输(灌输层),一些定义导体(多晶硅或金属层),一些定义传导层之间的连接(过孔或接触层)。所有的组件由这些层的特定组合构成。
在一个自排列(CMOS)过程中,所有门层(多晶硅或金属)穿过扩散层的地方形成晶体管。
电阻结构,电阻结构的长宽比,结合表面电阻系数,决定电阻。
电容结构,由于尺寸限制,在IC上只能产生很小的电容。
更为少见的电感结构,可以制作芯片载电感或由回旋器模拟。
因为CMOS设备只引导电流在逻辑门之间转换,CMOS设备比双级组件消耗的电流少很多。
随机存取存储器(random access memory)是最常见类型的集成电路,所以密度最高的设备是存储器,但即使是微处理器上也有存储器。尽管结构非常复杂-几十年来芯片宽度一直减少-但集成电路的层依然比宽度薄很多。组件层的制作非常像照相过程。虽然可见光谱中的光波不能用来曝光组件层,因为他们太大了。高频光子(通常是紫外线)被用来创造每层的图案。因为每个特征都非常小,对于一个正在调试制造过程的过程工程师来说,电子显微镜是必要工具。
在使用自动测试设备(ATE)包装前,每个设备都要进行测试。测试过程称为晶圆测试或晶圆探通。晶圆被切割成矩形块,每个被称为“die”。每个好的die 被焊在“pads”上的铝线或金线,连接到封装内,pads通常在die的边上。封装之后,设备在晶圆探通中使用的相同或相似的ATE上进行终检。测试成本可以达到低成本产品的制造成本的25%,但是对于低产出,大型和/或高成本的设备,可以忽略不计。
在2005年,一个制造厂(通常称为半导体工厂,常简称fab,指fabrication facility)建设费用要超过10亿美金,因为大部分操作是自动化的。
发展趋势
2001年到2010年这10年间,我国集成电路产量的年均增长率超过25%,集成电路销售额的年均增长率则达到23%。 2010年国内集成电路产量达到640亿块,销售额超过1430亿元,分别是2001年的10倍和8倍。中国集成电路产业规模已经由2001年不足世界集成电路产业总规模的2%提高到2010年的近9%。中国成为过去10年世界集成电路产业发展最快的地区之一。
国内集成电路市场规模也由2001年的1140亿元扩大到2010年的7350亿元,扩大了6.5倍。国内集成电路产业规模与市场规模之比始终未超过20%。如扣除集成电路产业中接受境外委托代工的销售额,则中国集成电路市场的实际国内自给率还不足10%,国内市场所需的集成电路产品主要依靠进口。近几年国内集成电路进口规模迅速扩大,2010年已经达到创纪录的1570亿美元,集成电路已连续两年超过原油成为国内最大宗的进口商品。与巨大且快速增长的国内市场相比,中国集成电路产业虽发展迅速但仍难以满足内需要求。
当前以移动互联网、三网融合、物联网、云计算、智能电网、新能源汽车为代表的战略性新兴产业快速发展,将成为继计算机、网络通信、消费电子之后,推动集成电路产业发展的新动力。工信部预计,国内集成电路市场规模到2015年将达到12000亿元。
我国集成电路产业发展的生态环境亟待优化,设计、制造、封装测试以及专用设备、仪器、材料等产业链上下游协同性不足,芯片、软件、整机、系统、应用等各环节互动不紧密。 “十二五”期间,中国将积极探索集成电路产业链上下游虚拟一体化模式,充分发挥市场机制作用,强化产业链上下游的合作与协同,共建价值链。培育和完善生态环境,加强集成电路产品设计与软件、整机、系统及服务的有机连接,实现各环节企业的群体跃升,增强电子信息大产业链的整体竞争优势。
发展对策建议
1.创新性效率超越传统的成本性静态效率
从理论上讲,商务成本属于成本性的静态效率范畴,在产业发展的初级阶段作用显著。外部商务成本的上升实际上是产业升级、创新驱动的外部动力。作为高新技术产业的上海集成电路产业,需要积极利用产业链完备、内部结网度较高、与全球生产网络有机衔接等集群优势,实现企业之间的互动共生的高科技产业机体的生态关系,有效保障并促进产业创业、创新的步伐。事实表明,20世纪80年代,虽然硅谷的土地成本要远高于128公路地区,但在硅谷建立的半导体公司比美国其他地方的公司开发新产品的速度快60%,交运产品的速度快40%。具体而言,就是硅谷地区的硬件和软件制造商结成了紧密的联盟,能最大限度地降低从创意到制造出产品等相关过程的成本,即通过技术密集关联为基本的动态创业联盟,降低了创业成本,从而弥补了静态的商务成本劣势 。
2.准确的产品与市场定位
许多归国创业的设计人才认为,中国的消费者是世界上最好的衣食父母,与欧美发达国家相比,我们的消费者对新产品充满好奇,一般不退货,基本无赔偿。这些特点为设计企业的创业、创新与发展提供了良好的市场机遇。企业要善于去发现产品应用,寻找市场 。
设计公司扩张主要是受限于人才与产品定位。由于在人才团队、市场和产品定义方面的不足,初创公司不可能做大项目,不适合于做集聚型大项目。现有的大多数设计企业还是适合于分散型市场,主动去支持系统厂商,提供大量的服务。人力密集型业务项目不适合欧美公司,更适合我们。例如,在国内市场上,如果一个产品能出货300万颗,那么公司就会去做,国外企业则不可能去做它 。
3.打造国际精英人才的“新故乡”,充分发挥海归人才优势
海归人才在国外做了很多超前的技术开发研究,并且在全球一些顶尖公司内有产业经验,回国后从事很有需求的产品开发应用,容易成功。集成电路产业的研发就怕方向性错误与低水平重复,海归人才知道如何去做才能够成功 。
“归国人才团队+海外工作经验+优惠政策扶持+风险投资”式上海集成电路产业发展的典型模式,这在张江高科技园区尤为明显。然而,由于国际社区建设滞后、户籍政策限制、个人所得税政策缺乏国际竞争力等多方面原因综合作用,张江仍然没有成为海外高级人才的安家落户、长期扎根的开放性、国际性高科技园区。留学生短期打算、“做做看”的“候鸟”观望气氛浓厚,不利于全球高级人才的集聚。要充分发挥张江所处的区位优势以及浦东综合
配套改革试点的政策优势,将单纯吸引留学生变为吸引留学生、国外精英等高层次人才。通过科学城建设以及个人所得税率的国际化调整、落户政策的优化,发挥上海“海派文化”传统,将张江建设成为世界各国人才汇集、安居乐业的新故乡,大幅提升张江在高层次人才争夺中的国际竞争力 。
4.重在积累,克服急功近利
设计业的复杂度很高,需要强大的稳定的团队、深厚的积累。积累是一个不可逾越的发展过程。中国集成电路产业的发展如同下围棋,不能只争一时之短长,要比谁的气长,而不是谁的空多。
集成电力产业人才尤其是设计人才供给问题长期以来是舆论界关注的热点,许多高校在专业与设置、人才培养方面急功近利,片面追随所谓社会热点和学业对口,导致学生的基本综合素质和人文科学方面的素养不够高,知识面过窄。事实上,众多设计企业普遍反映,他们招聘人才的标准并非是单纯的所谓专业对口,而是更注重基础知识和综合素质,他们普遍反映高校的教育太急功近利了 。
5.促进企业间合作,促进产业链合作
国内企业之间的横向联系少,外包刚刚起步,基本上每个设计企业都有自己的芯片,都在进行全面发展。这些因素都限制了企业的快速发展。要充分运用华南一些企业为国外做的解决方案,这样终端客户就可以直接将公司产品运用到原有解决方案上去。此外,设计企业要与方案商、通路商、系统厂商形成紧密的战略合作伙伴关系 。
6.摒弃理想化的产学研模式
产学研一体化一直被各界视为促进高新技术产业发展的良方,但实地调研结果暴露出人们在此方面存在着不切实际的幻想。笔者所调研的众多设计企业对高校帮助做产品不抱任何指望。公司项目要求的进度快,存在合作的时间问题;高校一般不具备可以使工厂能更有效利用厂房空间,也适用于研发中心的使用。新开发的空冷系统减少了对外部设施的依赖,可在任意位置安装设置,同时继续支持符合STC标准的各种T2000模块,满足各种测试的需要 。
其他信息
晶体管发明并大量生产之后,各式固态半导体组件如二极管、晶体管等大量使用,取代了真空管在电路中的功能与角色。到了20世纪中后期半导体制造技术进步,使得集成电路成为可能。相对于手工组装电路使用个别的分立电子组件,集成电路可以把很大数量的微晶体管集成到一个小芯片,是一个巨大的进步。集成电路的规模生产能力,可靠性,电路设计的模块化方法确保了快速采用标准化IC 代替了设计使用离散晶体管。
IC 对于离散晶体管有两个主要优势:成本和性能。成本低是由于芯片把所有的组件通过照相平版技术,作为一个单位印刷,而不是在一个时间只制作一个晶体管。性能高是由于组件快速开关,消耗更低能量,因为组件很小且彼此靠近。 2006年,芯片面积从几平方毫米到350 mm2,每mm2可以达到一百万个晶体管。
第一个集成电路雏形是由杰克·基尔比于1958年完成的,其中包括一个双极性晶体管,三个电阻和一个电容器。
根据一个芯片上集成的微电子器件的数量,集成电路可以分为以下几类:
1.小规模集成电路
SSI 英文全名为 Small Scale Integration, 逻辑门10个以下 或 晶体管 100个以下。
2.中规模集成电路
MSI 英文全名为 Medium Scale Integration, 逻辑门11~100个 或 晶体管 101~1k个。
3.大规模集成电路
LSI 英文全名为 Large Scale Integration, 逻辑门101~1k个 或 晶体管 1,001~10k个。
4.超大规模集成电路
VLSI 英文全名为 Very large scale integration, 逻辑门1,001~10k个 或 晶体管 10,001~100k个。
5.甚大规模集成电路
ULSI 英文全名为 Ultra Large Scale Integration, 逻辑门10,001~1M个 或 晶体管 100,001~10M个。
GLSI 英文全名为 Giga Scale Integration, 逻辑门1,000,001个以上 或 晶体管10,000,001个以上。
而根据处理信号的不同,可以分为模拟集成电路、数字集成电路、和兼具模拟与数字的混合信号集成电路。
集成电路发展
最先进的集成电路是微处理器或多核处理器的"核心(cores)",可以控制电脑到手机到数字微波炉的一切。存储器和ASIC是其他集成电路家族的例子,对于现代信息社会非常重要。虽然设计开发一个复杂集成电路的成本非常高,但是当分散到通常以百万计的产品上,每个IC的成本最小化。 IC的性能很高,因为小尺寸带来短路径,使得低功率逻辑电路可以在快速开关速度应用。
这些年来,IC 持续向更小的外型尺寸发展,使得每个芯片可以封装更多的电路。这样增加了每单位面积容量,可以降低成本和增加功能-见摩尔定律,集成电路中的晶体管数量,每两年增加一倍。总之,随着外形尺寸缩小,几乎所有的指标改善了-单位成本和开关功率消耗下降,速度提高。但是,集成纳米级别设备的IC不是没有问题,主要是泄漏电流(leakage current)。因此,对于最终用户的速度和功率消耗增加非常明显,制造商面临使用更好几何学的尖锐挑战。这个过程和在未来几年所期望的进步,在半导体国际技术路线图(ITRS)中有很好的描述。
越来越多的电路以集成芯片的方式出现在设计师手里,使电子电路的开发趋向于小型化、高速化。越来越多的应用已经由复杂的模拟电路转化为简单的数字逻辑集成电路。
IC的普及
仅仅在其开发后半个世纪,集成电路变得无处不在,电脑,手机和其他数字电器成为现代社会结构不可缺少的一部分。这是因为,现代计算,交流,制造和交通系统,包括互联网,全都依赖于集成电路的存在。甚至很多学者认为有集成电路带来的数字革命是人类历史中最重要的事件。
IC的分类
集成电路的分类方法很多,依照电路属模拟或数字,可以分为:模拟集成电路、数字集成电路和混合信号集成电路(模拟和数字在一个芯片上)。
数字集成电路可以包含任何东西,在几平方毫米上有从几千到百万的逻辑门,触发器,多任务器和其他电路。这些电路的小尺寸使得与板级集成相比,有更高速度,更低功耗并降低了制造成本。这些数字IC, 以微处理器,数字信号处理器(DSP)和单片机为代表,工作中使用二进制,处理1和0信号。
模拟集成电路有,例如传感器,电源控制电路和运放,处理模拟信号。完成放大,滤波,解调,混频的功能等。通过使用专家所设计、具有良好特性的模拟集成电路,减轻了电路设计师的重担,不需凡事再由基础的一个个晶体管处设计起。
IC可以把模拟和数字电路集成在一个单芯片上,以做出如模拟数字转换器(A/D converter)和数字模拟转换器(D/A converter)等器件。这种电路提供更小的尺寸和更低的成本,但是对于信号冲突必须小心。
